在芯片切割分析的过程中,必须使用高精度的切割器材将芯片切成薄片,接着通过电子显微镜等设备来观察和分析这些切片。这项技术有助于研究人员认识芯片的性能瓶颈,优化芯片的设计,提升芯片的性能和可靠度。
除此之外,芯片切片分析还可用于故障检测和质量控制。通过对出现故障的芯片进行切片分析,可以查明故障原因和位置,为修复和改进工作提供有力支持。同时,切片分析也可用于评估芯片生产过程中的质量控制水平,以确保产品符合规格和要求。
一、 切片方式的介绍
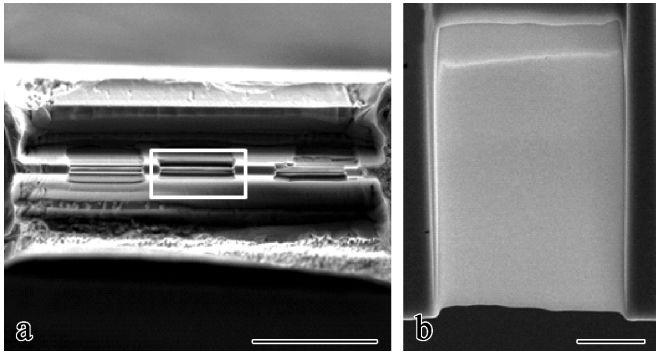
1、机械研磨
机械切片是一项低成本的切片技术,由于精度较低、操作步骤相对复杂,较少应用于芯片的结构的截面观察。为了在条件不足的情况下对芯片结构进行观察,本文对芯片切片做了详细的说明,该方法可满足大部分情况下对芯片结构观察的需要。
这方式最为简单使用,针对各式各样的产品或材质皆可以快速执行,如金属、陶瓷、粉末、电子产品等。机械研磨可做大面积的观测范围(数微米到数厘米的宽度)。
缺点是研磨过程中容易产生机械应力效应,如变形、弯曲、刮痕、裂缝等人为缺陷存在试样表面或界面,造成观察的误判。下图显示研磨过程的各种缺陷。
机械切片主要包括取样,镶嵌,研磨和抛光。取样应根据被检样品的检验目的,还须考虑取样方法和样品是否需要装用夹具或镶嵌等。镶嵌的目的:根据样品材料和检测要求等,通过选择不同镶嵌材料来满足边缘,易碎样品保护及方便握持,目前半导体行业使用较多的是环氧树脂镶嵌,具有收缩率低,透明度高与试样附着好等优点。研磨和抛光的主要目的,使试样表面的损伤逐渐减小直到理论上为零的过程,获得光亮无划痕的金相表面。
裸芯片目前主要成分还是以硅为主,而且体积较小,材质较脆,妍磨过程中容易碎裂,所以产品机械研磨必须镶嵌后才能进行,但是芯片镶嵌后样品凝固在镶嵌树脂内,无法看不到样品状态和压区位置,不能有效定位。而且芯片表面金属层以铝为主,具有延展性,在抛光研磨过程中,抛光布摩擦作用会导致芯片铝层产生延展甚至脱落,导致研磨失败。
所以,通过机械切片的方式改变目前切割裸芯片方法,有效解决了之前研磨存在的无法定位,铝层脱开,延展等问题,大大提高了客户满意度,也解决了时效性的问题,最主要的是降低了研磨切片成本。
2、CP(Cross-section Polisher)
CP其操作原理是利用文件板将目标物遮住,再用离子束切割,作用时间长短可控制出观察范围的大小,试样切割出可观察的区域呈现U字型(如下图)。针对不同的样品的硬度,制备出镜面样品。
此方式可以避免在研磨过程中所产生的应力、刮痕、抛光液粒子的残留,完成的样品表面光滑无损伤,同时可以表现出材料内部的真实结构,有利于后续使用SEM、EDS或其它分析设备对样品进行进一步的观察和分析。
3、Dual Beam FIB
在当今的微观世界研究中,聚焦离子束(Focused Ion Beam,FIB)已经成为一种不可或缺的工具。它具有极高的精度和灵活性,使得科学家能够在纳米级别上对材料进行精确的加工和观测。其中,聚焦离子束FIB切片技术更是广泛应用于材料科学、生物学、医学等领域。本文将详细介绍聚焦离子束FIB切样的原理、特点及应用。
而DBFIB是结合了聚焦离子束(FIB)和扫描电子显微镜(SEM),其中离子束可用于去除特定位置的材料,而SEM可用于无损成像和分析。图五介绍了双光束系统配置,其切割和侧面观察的方向及夹角架构。DBFIB是目前切片设备中精准度最高的利器,可以精准至纳米等级这是其他方式无法达成的境界,其优势是切片的范围在数十至数百微米之内,适合小范围的精密切片。
下面主要跟大家分享一下这个聚焦离子束(FIB)切片的相关知识:
1、聚焦离子束(FIB)切片原理
聚焦离子束(FIB)切片技术的基本原理是利用高能离子束将目标样品进行切割。首先,通过离子源产生离子束,经过聚焦透镜和扫描电极后,形成极细的离子束。该离子束在样品表面聚焦并扫描,通过物理撞击和化学反应,将目标样品逐层剥离,从而实现切割。在聚焦离子束(FIB)切片过程中,离子束的能量密度和扫描速度是关键因素。能量密度决定了切割效率,而扫描速度则决定了切割精度。通过精确控制这些参数,可以实现不同样品和不同需求的切割。此外,为了确保切割的精确度和样品完整性,聚焦离子束(FIB)切片过程中通常需要辅助气体或液体流,以对切割过程中产生的样品残渣进行吹扫和冷却。
2、聚焦离子束(FIB)切片技术特点
(1)高精度和灵活性
聚焦离子束(FIB)切片技术具有极高的精度和灵活性,可以实现在纳米级别上的切割。这使得科学家能够在微观尺度上对材料进行深入研究。
(2)样品无损
由于聚焦离子束(FIB)切片过程中仅通过物理撞击和化学反应剥离样品,因此对样品的损伤极小,能够保持样品的完整性。
(3)可加工复杂形状样品
聚焦离子束(FIB)切片技术不仅适用于平面样品,还可加工复杂形状的样品,如三维纳米结构、微纳器件等。
(4)可集成其他微观操作技术
聚焦离子束(FIB)系统可以集成其他微观操作技术,如电子束曝光、扫描隧道显微镜,TOFSIMS等,从而实现更复杂的微观操作。
3、聚焦离子束(FIB)切片技术的应用
(1)半导体制造:在半导体制造领域,聚焦离子束(FIB)切片技术广泛应用于芯片结构分析、芯片逆向解剖、失效分析等方面。通过对失效芯片进行切割和观测,可以深入了解芯片失效原因,提高芯片制造质量。
(2)生物学研究:在生物学研究中,聚焦离子束(FIB)切片技术被用于切割细胞和组织样品,以进行后续的观测和分析。例如,通过对动物胚胎进行切割和观测,可以了解胚胎发育过程中的细胞分裂和分化情况。
(3)医学诊断与治疗:在医学领域,聚焦离子束(FIB)切片技术也得到了广泛应用。例如,通过对人体组织样本进行切割和观测,可以辅助医生进行疾病诊断和治疗方案的制定。此外,该技术还可用于药物研发过程中的药物筛选和测试。
(4)材料科学研究:在材料科学研究领域,聚焦离子束(FIB)切片技术用于切割各种材料样品,以进行结构分析、物相鉴定和应力测试等。例如,通过对金属材料进行切割和观测,可以了解材料的力学性能和微观结构之间的关系。
(5)考古学与文物保护:在考古学和文物保护领域,聚焦离子束(FIB)切片技术用于切割和分析古物样品。例如,通过对古代陶瓷进行切割和观测,可以了解陶瓷的制作工艺和技术发展历史。同时,该技术还可用于文物的修复和保护工作中。
(6)环境监测与污染治理:在环境监测与污染治理领域,聚焦离子束(FIB)切片技术用于切割和分析环境样品。例如,通过对土壤和水样。
4、聚焦离子束(FIB)切片技术的应用案例
(1)电镀品截面镀层结构分析 :客户委托我司对客诉异常电镀产品聚焦离子束(FIB)-SEM分析,聚焦离子束(FIB)切割电镀品内部结构图及SEM背散射(BSE)图:
(2)微米级缺陷样品聚焦离子束(FIB)-SEM截面测试:
(3)PCB电路断裂位置,利用SEM观察铜箔金相:
(4)聚焦离子束(FIB)切割锡球截面分析:
(5)聚焦离子束(FIB)切割晶粒分析:
(6)PCB线路板失效聚焦离子束(FIB)切割铜层晶粒分析(离子束成像):
二、关键技术和应用
1、样品制作:特别是透射电镜(TEM)及扫描式电镜(SEM)试样制作。
2、精准缺陷及制程工艺切片:精准度可应用于5nm以下的先进制程工艺。
3、失效点VC(Voltage Contrast)定位:可以定位精准到单个晶体管位置。
4、SEM取向衬度:可以依晶粒对比分析晶粒大小。
5、IC线路修补:
以下方表格归纳出三种切片方式可以达到的需求及存的缺点,有助于客户判断产品或分析出规格对应的最佳切片工具。
总结一下
总的来说,芯片的切片分析是一项关键的技术工具,对于深入了解芯片的性能和优化芯片设计具有重要意义。
但是,随着半导体封装工艺越来越多样,芯片种类也越来越多样化,对芯片切片是观察其内部结构的主要途径,特别是对于很多封装厂来说,由于缺乏对芯片结构的了解,在产品导入过程时,往往缺乏一些可以考量的依据,如:铝层厚度多少,芯片内部线路结构如何等等问题,而目前市场上针对裸芯片的切片往往采用精确剖面切片如聚焦离子束(FIB) ,价钱较为昂贵,时效性也很难把控。而且大部分芯片厂和封装厂都不具备这些条件,所以研究低成本的切片技术很有必要。因此,对于半导体芯片的切片分析来说,是选择传统的机械切片还是使用先进的聚焦离子束(FIB),这也得看应用场景和自己的预算吧!
-----End-----
免责声明:我们尊重原创,也注重分享;文字、图片版权归原作者所有。转载目的在于分享更多信息,不代表本号立场,如有侵犯您的权益请及时联系,我们将第一时间删除,谢谢!


